在許多人印象裡,半導體製造拼的是更小的線寬、更高的層數、更複雜的結構。
但在真正的晶圓廠裡,最容易被忽視、也最容易吞掉良率的,往往不是晶圓中央那一片“精密戰場”,而是最外圈那一圈邊緣。
工程上常說的“洗邊”,並不是把晶圓邊上簡單洗一洗,而是一組圍繞晶圓邊緣區、倒角區和背面邊緣區展開的工藝動作:
去除不該留在邊上的膠、金屬、介質膜、聚合物和顆粒,必要時還要做保護、整形甚至邊緣輪廓控制。
它既存在於光刻,也存在於蝕刻、濕式清洗、電化學鍍銅,甚至會一路延伸到晶圓鍵合和先進封裝。
為什麼邊緣這麼重要?
因為晶圓邊緣並不是「與晶片無關的廢區」。
- 一方面,倒角和邊緣是薄膜終止、應力釋放、搬運接觸、污染遷移最活躍的區域;
- 另一方面,先進製造又在不斷壓縮邊緣保留區,希望把更多周邊面積變成可用晶片區。
Lam、EBARA、Bruker等廠商近年的公開資料都把wafer edge(晶圓邊緣)從「輔助區域」升級成了明確的yield-limiting region(限制良率區域)。
更值得注意的是,清洗本來就是晶圓製造裡的高頻動作。
MKS的半導體清洗資料提到,現代裝置製造中各類清洗步驟可佔總製程步驟的30%—40%;而隨著etch(Etch,蝕刻)、deposition(Deposition,沉積)以及2.5D/3D封裝結構不斷增多,清洗的重要性仍在持續上升。
換句話說,洗邊不是“邊角料工藝”,而是先進製造把良率做穩、把邊緣die救回來的必修課。
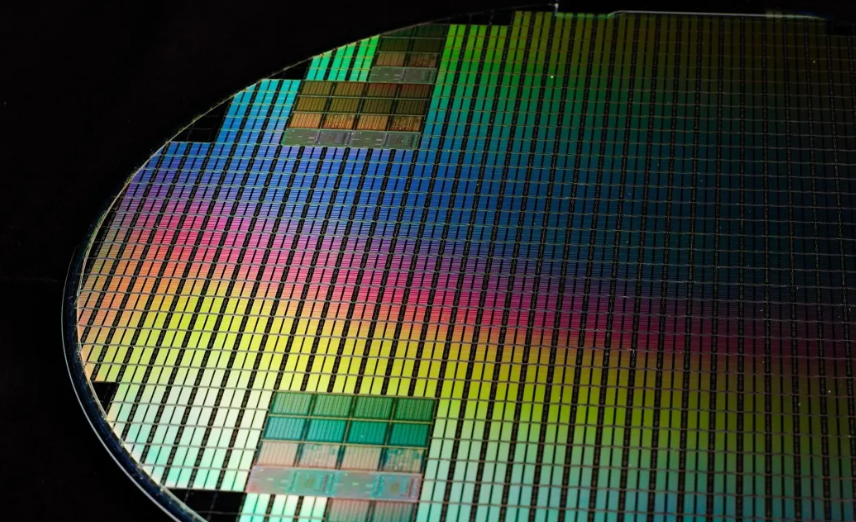
01 先搞清楚:半導體裡的“洗邊”,到底在洗什麼
嚴格說,晶圓「邊」並不是一條線,而是一整圈複雜的三維區域。
公開資料通常會把它拆成top edge(正面邊緣)、bevel(倒角/斜邊)、backside edge(背面邊緣)以及與工藝和量測相關的edge exclusion(邊緣排除區)。
這些區域雖然不承擔核心裝置功能,卻承擔著應力過渡、機械支撐、搬運定位和製程終止的角色,因此也是最容易累積膜層重疊、顆粒、金屬污染和機械損傷的地方。
很多人會誤以為,既然邊緣本來就不做電路,出點問題也無所謂。
恰恰相反,邊緣最大的危險在於「向內傳播」。
例如邊緣薄膜剝落後形成顆粒,會在後續設備中二次沉積到AA(Active Area,有源區);再例如邊緣的金屬、摻雜物或有機殘留,會透過搬運夾持、對準銷、FOUP(Front Opening Unified Pod,前開式晶圓傳送盒)接觸轉移,形成跨片、跨批次污染。
邊緣問題之所以難纏,不是因為它只會傷害邊緣,而是因為它有能力把污染帶進中心。
02 Litho洗邊:真正要解決的,不只是“邊上那圈膠”
說到洗邊,業界最熟悉的一類就是光刻洗邊。
光刻塗膠時,photoresist(光阻)透過spin coating(旋塗)鋪在晶圓表面,離心甩膠的結果之一,就是多餘膠液天然更容易堆積到外圍,形成edge bead(邊珠/邊緣厚膠)。
這不是設備“失誤”,而是高分子流體在旋塗過程中的典型現象,尤其在高黏度、厚膠製程更明顯。
這圈邊珠為什麼必須去掉?
原因至少有三層。
- 第一,它會影響曝光與對焦,造成stepper(步進式曝光機)或aligner(對準曝光機)在邊緣區域的高度判斷失真;
- 第二,它可能翻包到背面,污染chuck(吸盤/載台)和後續設備接觸介面;
- 第三,邊緣乾掉的膠會在搬運和夾持時崩裂成顆粒,變成後續刻蝕、沉積和清洗中的隱形污染源。
因此,光刻洗邊不只是單一動作,而是一套組合拳。
- 常見做法包括topside chemical EBR(正面化學洗邊),即用溶劑精準溶掉邊緣不需要的膠;
- BSR(Backside Rinse,背洗),即把翻包到背面的膠和溶劑殘留沖掉;
- 以及OEBR(Optical Edge Bead Removal,光學洗邊/光學去邊珠),透過邊緣曝光讓這圈膠在後續顯影中被選擇性去除。
更有趣的是,EBR本身如果沒調好,也會「製造缺陷」。
美國能源部收錄的一篇2025年研究顯示,photoresist cast time(光刻膠旋塗鋪展時間)和EBR rinse time(EBR沖洗時間)過短時,邊緣會出現encroachment(侵入)和所謂rainbow defects(彩虹缺陷);而在工藝參數優化後,EBR誘發缺陷幾乎被完全消除。
這個細節非常說明問題:光刻洗邊的本質不是“洗掉越多越好”,而是把邊界位置、去除寬度、殘留控制和顆粒控制同時做到穩定。
03 ET洗邊:蝕刻做完了,真正危險的殘留往往才剛開始
很多人把洗邊理解成“光刻的專屬動作”,其實不對。
進入ET(Etch,蝕刻)和strip/ash(去膠/灰化)階段後,邊緣問題往往更複雜。
原因在於,等離子蝕刻不會只在晶圓中央發生作用,邊緣的膜層終止處、堆疊斷面、應力集中區更容易形成不規則殘留、粗糙化和局部損傷。
Lam公開資料直接指出,bevel etch(倒角刻蝕/邊緣蝕刻)的目的,就是在不同製造步驟之間移除晶圓邊緣不需要的mask(掩膜材料)、residue(殘留物)和films(薄膜),否則這些材料會剝落並再沉積到裝置區域,哪怕只有一個關鍵顆粒落到敏感結構上,也可能讓整顆晶片失效。
對蝕刻來說,邊緣殘留不僅是“髒”,還可能是“危險”。
Lam在其邊緣製程資料中提到,金屬膜若殘留在邊緣,也可能在後續plasma etch(等離子刻蝕)或deposition(沉積)過程中誘發arcing(打弧)。
而2024年Micron作者發表於JVB(Journal of Vacuum Science & Technology B,真空科學與技術B)的論文則指出,wafer backside(晶圓背面)和frontside bevel(正面倒角)上的聚合物殘留會帶來顯著良率損失。
傳統額外的ex situ bevel etch(機外倒角清理)能清掉部分邊緣堆積,卻不一定解決背面問題,因此他們開發了in situ pin-up clean(原位pin-up清洗)來同時處理背面與邊緣倒角殘留。
這也是為什麼很多先進廠不會把ET洗邊理解成“刻蝕後補一刀”,而是把它當作整個蝕刻整合的一部分。
特別是在immersion lithography(浸沒式微影)和多層BEOL(Back End Of Line,後段金屬互連)流程中,邊緣完整性被反覆強調,因為邊緣殘留和顆粒可能隨著液體、搬運和後續等離子過程被重新帶回前表面,最終變成你在缺陷圖上根本認不出的「飛來橫禍」。
04 WET洗邊:濕法不是“傳統製程”,而是邊緣治理的高精度工具
再往下看,WET(Wet Clean / Wet Etch,濕式清洗/濕蝕刻)洗邊是許多先進製程線上的主力選手。
它的核心想法不是靠高能量等離子轟擊,而是利用化學選擇性,把邊緣不想要的介質膜、金屬膜、有機膜以及顆粒在受控區域內溶掉或剝離掉。
ACM Research的資料寫得很直接:其Bevel Etch(邊緣濕式蝕刻)系統可以去除wafer edge(晶圓邊緣)上的dielectric(介質)、metal(金屬)和organic material films(有機材料薄膜),也能處理顆粒污染;
而且相對dry process(乾式製程),濕法還能避免arcing和silicon damage(矽損傷)風險。
為什麼濕法在邊緣特別有優勢?
因為邊緣最怕兩件事:一是誤傷有源區,二是邊界不可控。
單片式濕式設備通過精確控液、控轉速、控噴射窗口,可以把「洗掉的區域」壓在很窄、很穩定的邊帶內,同時盡量不碰中間的功能區。
TEL在其CELLESTA單片清洗設備資料中強調,其wafer retention(晶圓保持)技術可以處理先前很難清潔到的outermost wafer edge and bevel(最外圈邊緣與倒角),並實現先進裝置製造所需的高顆粒控制。
更關鍵的是,WET洗邊並不是只在一個階段使用。
ACM明確寫到,bevel etch既會在front end(前段)銅互連之前做,也會在back end(後段)銅互連之後做。
這說明邊緣清理不是“某一步專屬”,而是隨著材料體系變化反复插入的工程動作:前段是為了把邊緣的介質、有機殘留和污染清乾淨,後段則更多面向金屬、顆粒和多層堆疊後的複合殘留。
你會發現,真正成熟的工藝線從來不把洗邊當一次性動作,而是把它當成材料切換之間的「防串擾隔離帶」。
05 ECP洗邊:銅不會乖乖隻長在你希望它長的地方
如果說哪一類洗邊最能體現“邊緣問題會直接殺傷量產”,ECP(ElectroChemical Plating,電化學鍍)一定排得上號。
銅互連和先進封裝大量使用electroplating(電鍍/電化學沉積),但只要發生電鍍,工程師就必須同時思考:
- 電流是怎麼分佈的?
- seed layer(種子層)怎麼連續導通?
- 夾持和密封能不能完全遮住不該鍍的位置?
早期關於銅互連邊緣問題的資料就已經指出,電鍍後最典型的邊緣麻煩包括barrier/seed residue(阻擋層/種子層殘留)和copper islands(銅孤島)。
這類問題不會老實待在邊上:它們可能在後續CMP(Chemical Mechanical Planarization,化學機械平坦化)前引入額外污染,也可能透過搬運和接觸跨片傳播。
Applied Materials當年的Electra Cu Integrated ECP公開資料則進一步說明,量產平台會把copper deposition(銅沉積)、anneal(退火)和wafer edge clean(晶圓邊緣清潔)集成在同一平台上,在雙Bevel Cleanbackside 和rim(背面與邊緣圈)上的多餘銅,再進行spin/rinse/dry(甩乾/清洗/乾燥)和退火,以兼顧吞吐量與污染控制。
這就是為什麼業界常把ECP洗邊視為「銅製程能否真正量產」的分水嶺。
你可以把電鍍理解為“把銅長出來”,但對工藝整合而言,真正困難的是“只讓銅長在該長的地方”。
一旦邊緣和背面除銅做不穩,後面每一步都要為此付出代價。
也正因如此,ECP洗邊經常不是孤立步驟,而是與seed/barrier去除、背面清潔、邊緣排除寬度控制一起被打包考核。
06 沉積、CMP、鍵結、先進封裝也都在“做邊緣工程”
如果你把洗邊只理解成“去除邊緣髒東西”,那還是低估了它。
到了先進邏輯、3D NAND、TSV(Through Silicon Via,矽通孔)和hybrid bonding(混合鍵結)時代,邊緣治理已經從「清洗」擴展成「清洗+保護+整形+量測」的系統工程。
Lam的Coronus資料提到,某些場景不是把邊緣膜全部去掉,而是在bevel(倒角)上沉積一層保護膜,防止長時間濕法蝕刻造成邊緣基底損傷;
在3D packaging(3D封裝)中,這層邊緣保護還能幫助降低edge chipping(邊緣崩邊)和profile roll-off(輪廓下塌)對wafer bonding(晶圓鍵合)品質的影響。
同時,CMP、減薄、邊緣修整也把「邊緣輪廓」推到了台前。
Bruker最新的edge roll-off metrology(邊緣捲落量測)資料指出,ERO(Edge Roll-Off,邊緣捲落)可能來自grinding(研磨)、CMP、coating(塗覆)和edge trimming(邊緣修整)等多種工藝;
而在先進封裝和wafer-to-wafer hybrid bonding(晶圓對晶圓混合鍵合)場景下,邊緣輪廓、微裂紋、粗糙度與共面性都可能直接影響鍵合可靠性和周邊die回收率。
再往前一步,EBARA的邊緣拋光系統甚至把「洗邊」做成了物理整形。
其公開資料顯示,bevel polishing system(倒角拋光系統)不只是清掉缺陷和多餘膜層,還會同時處理top edge、bevel和backside edge,並透過配方控制實現高精度邊緣輪廓管理。
07 洗邊製程的本質,是把“邊緣不確定性”變成“邊緣可控性”
如果把前面的工藝拆開看,你會發現不同部門雖然設備不同、材料不同、化學品不同,但洗邊背後的工程邏輯其實高度一致。
第一,辨識邊緣上到底有什麼
- 是光阻?
- 是灰化後的聚合物?
- 是銅、阻擋層、種子層?
- 是介質膜、金屬膜疊層?
- 還是機械性損傷和粗糙化?
第二,把「不該碰的中間區域」和「必須清的邊帶」切清楚
無論是光刻的EBR,還是濕法Bevel Etch,核心都不是“洗得越寬越安全”,而是在保證邊界穩定和顆粒可控的前提下,把edge exclusion(邊緣排除)盡量壓小,讓更多周邊die回到可用區。
第三,把洗邊從“補救動作”變成“集成動作”
最成熟的製程線不會等缺陷暴露了再去補邊,而是在光刻、刻蝕、濕法、電鍍、鍵合等關鍵切換點主動插入邊緣治理步驟,提前切斷顆粒遷移、金屬串擾、背面污染和輪廓失控的路徑。
所以,所謂晶圓洗邊,本質上不是「把邊上洗乾淨」這麼簡單,而是在先進製造裡,用一整套可重複、可量測、可量產的手段,把邊緣這個最容易出事故的區域,變成可工程化管理的區域。
中心區拼的是奈米級圖形,邊緣區拼的是系統級製程整合;誰把邊緣管住了,誰才真正把良率握在自己手裡。

